1 EINLEITUNG: KLASSISCHE LITHOGRAPHIE
2.1.2 Experimenteller Aufbau
2.2.2 Dipolkraft 2.2.3 Experimenteller Aufbau 2.2.4 Intensitätsgradienten-Lichtmasken 2.2.5 Polarisationsgradienten-Lichtmasken 2.2.6 Begrenzende Prozesse
3.2 RESISTTECHNIK 3.3 GRENZEN DER VERFAHREN 5 LITERATUR 6 [ Druck-optimierte Version ] |
AtomlithographieMark Rossi
|
Zwei Verfahren, die als potentielle Nachfolger der klassischen Lithographie gehandelt werden sollen in diesem Rahmen besprochen werden. Es werden in der Folge die dahinterstehenden Grundprinzipien, die Apparaturen und die Grenzen der Verfahren vorgestellt und näher betrachtet, vor allem in Hinsicht auf die l/2-Grenze der hochgezüchteten Photolithographie.
Der erste Ansatz ist, den Atomstrahl durch eine Magnetfeld abzulenken. Da die magnetische Flußdichte im Inneren eines wie in Abbildung 12 angeordneten Hexapol-Permanentmagneten proportional zum Quadrat des Abstandes zur Achse ist, erfahren die Atome ein direkt zum Abstand proportionales Kraftgefälle; analog zu einer optischen Linse (genauer: dünne Linse). Innerhalb des Gültigkeitsbereiches der Dünnen-Linse-Näherung, also für kurze Hexapole, ist die Brennweite eine quadratische Funktion der Atomgeschwindigkeit.
Diese Abhängigkeit wird auch klar, wenn man die Verweildauer (abhängig von der Atomgeschwindigkeit und der Linsendicke) der Atome im ablenkenden Feld betrachtet.
Den Winkel a erhält man aus dem Verhältnis des Impulses p zur Impulsänderung Dp aufgrund der Kraft F für die Dauer der Krafteinwirkung Dt:
 |
(6) |
 |
(7) |
und damit hängt die Weite des Brennpunktes f quadratisch von der Geschwindigkeit der Atome ab:
 |
(8) |
Ein Hexapol-Permanentmagnet wird in der Art eines Diaprojektors benutzt, um Strukturen vergrößert oder verkleinert abzubilden. Zunächst wird der Atomstrahl, in [1] wurde ein Cs-Strahl benutzt, mittels Laser und der light chirp-Technik (siehe dazu auch Vortrag: Laserkühlung von Ralf Härle) bis auf 150 m/s verlangsamt, abgekühlt und polarisiert. Eine mechanische Abdeckung verhindert, daß bei einmal begonnenem Kühlungszyklus thermische Atome mit circa 300 m/s dem Ofen entkommen und zur gleichen Zeit im Abbildungsgebiet ankommen, wie die gekühlten, langsamen Atome. Die Kühlapparatur wird mit Erreichen der Abbildungsmaske abgeschaltet.
Die Maske selbst besteht aus einem dünnen transparenten Stück Poly-Methyl-Methacrylat (PMMA, wird auch als Elektronenresist benutzt), in welches Löcher gebohrt worden sind und wird off-axis montiert, um nachher in der Detektion den Schatten der schnellen Atome besser vom invertierten Bild unterscheiden zu können. Nach passieren der Maske fliegen die Atome durch den Hexapolmagneten.
Am Ende des Aufbaus fliegt der Atomstrahl durch eine Ebene resonanten Laserlichtes. Die dabei entstehende Fluoreszenz wird mit einer CCD-Kamera (charge-coupled device) aufgenommen. Zudem wird die Kamera nur aktiviert, wenn die abbildenden Atome durch die Detektionszone fliegen, um eine Detektion der schnellen Atome zu verhindern, die zu schnell waren , um eine ausreichende Ablenkung durch den Hexapol zu erfahren.
Es wurden Brennpunktsdurchmesser von 200 µm erreicht. Es konnte außerdem anhand der Ergebnisse sowohl eine Verkleinerung (Faktor 0,8; Abbildung 15 (1) links), als auch eine Vergrößerung (Faktor 1,4; Abbildung 15 (2) rechts) der PMMA-Maske erreicht werden.

Ist eine hintergrundfreie Abbildung erwünscht, kann man mittels weiterer nichtaxialer Magnetlinsen ein atom-optisches Teleskop einbringen. Dann ist auch keine für den Kühllaser transparente Maske mehr erforderlich.
Durch den off-axis-Aufbau werden die Linsenaberrationen in den äußeren Teilen des Bildes stärker betont. Überhaupt kann man an diesem Aufbau all die aus der Optik bekannten Linsenfehler beobachten. Hier sind vor allem longitudinale und transversale chromatische Aberration von Bedeutung. Weiterhin leidet die Abbildungsqualität durch nicht perfekte Kollimation und Polarisation des Atomstrahls, Abweichungen vom idealen magnetischen Hexapol, Gravitation und atomaren Kollisionen.
Aber gerade der chromatischen Aberration kann man durch gute Präparation (Laserkühlung) des Atomstrahls entgegenwirken. (Optimistische) Numerische Simulationen unter Betracht aller Aberrationen zeigen eine minimale Brennpunktgröße von 50 nm, was dieses Verfahren interessant für Anwendungen in der Lithographie macht. Es kann sogar mit einer Lichtmaske kombiniert werden.
Das hier vorgestellte Verfahren ist allgemein anwendbar auf Atome, die ein Dipolmoment aufweisen. Spezielles Equipment ist nur zur Präparation des Atomstrahls (Laser) nötig.
Alle bisher eingesetzten Lichtmasken entstehen durch den Überlapp von zwei bis vier Laserstrahlen gleicher Wellenlänge, die in einer Ebene senkrecht zum Atomstrahl verlaufen. In dieser Ebene ergibt sich ein periodisches Lichtfeld, daß seine Periodizität (unter bestimmten Bedingungen: "Nahe-Resonanz") dem durch es hindurchlaufenden Atomstrahl aufprägt.
Wegen des resonanten Charakters der Atom-Licht-Wechselwirkung hängen die Lichtkräfte empfindlich von der Laserfrequenz ab und können bei minimaler Frequenzänderung sogar ihr Vorzeichen umkehren.
Zudem reagieren Atome sehr sensitiv auf die Polarisation des Lichtfeldes. Dieser Umstand ermöglicht es Lichtmasken mit gleichbleibender Intensität und ortsabhängiger Polarisation zu verwirklichen.
Die Wirkung der Lichtkräfte beruht auf der Tatsache, daß einige Atome des Atomstrahls Photonen des Laserstrahls absorbieren und wieder emittieren. Je nachdem, ob nun diese Emission spontan oder stimuliert geschieht unterscheidet man nach Spontan- und Dipolkraft.
Die dissipative Spontankraft, oder auch Strahlungsdruck, wird zur Laserkühlung benutzt. Insbesondere der Erhöhung der Konstanz der transversalen Geschwindigkeitsverteilung kommt, wie wir später noch sehen werden, eine tragende Rolle zu, da die Wirkung der Lichtlinsen auf ein sich bewegendes Atom geschwindigkeitsabhängig ist. Außerdem kann man durch Herabsetzung der longitudinalen Geschwindigkeit im allgemeinen, zusätzlich zu einer Einengung der longitudinalen Geschwindigkeitsverteilung, größere Ablenkungen der Atome durch Linsenkonstrukte erreichen. Die Apparaturen verlangen räumlich weniger Platz.
Die Dipolkraft entsteht durch Induktion eines Dipolmomentes im Atom beim Durchqueren eines Lichtfeldes. Die daraus resultierende Polarisationsenergie führt in inhomogenen Lichtfeldern zu einer konservativen Kraft.
 |
(9) |
Die klassische Wechselwirkungsenergie, die als Potential V auf das Atom wirkt, ergibt sich aus dem über die optische Periode gemittelten Produkt von elektrischem Wechselfeld E und induziertem schwingendem Dipolmoment d.
Dabei ist die Dipolkraft über die Intensität ortsabhängig. Diesen Umstand nutzt man zur Konstruktion von Linsen. Setzt man zum Beispiel eine mittels Laser erzeugte Stehwelle als Linse ein, so kann man Linsen in der Größenordnung (der Hälfte) der Wellenlänge des Lasers herstellen.
Die Dipolkraft hängt zudem noch vom Vorzeichen der Laserverstimmung ab. So wird das Atom bei Blauverstimmung in Richtung der Intensitätsminima beschleunigt. Bei Rotverstimmung kommt es zu einer Inversion des Potentials. Das Atom erfährt für eine Lichtfrequenz w unterhalb der Resonanzfrequenz w0, wo das Dipolmoment des getriebenen Oszillators gleichphasig schwingt, eine Kraft in Richtung zunehmender Intensität. Oberhalb schwingt der Oszillator gegenphasig, die Kraft wirkt in Richtung abnehmender Intensität (siehe dazu Abbildung 17).
Prinzipiell aber ist der Versuchsaufbau, bis auf die Polarisation des Lasers zur Erzeugung der Lichtmaske, identisch. Ein Ofen erzeugt bei circa 1650°C (für Chrom) mit einer im Durchmesser 1,5 mm großen Öffnung einen Atomstrahl. Die longitudinale Geschwindigkeit der Atome liegt hier noch bei etwa 1200 m/s. Es wird ein Fluß erzeugt, der in 0,8 m Entfernung eine Ablagerung von 2 nm/min sicherstellt.
Mit 83,8% ist das häufigste vorkommende Isotop 52Cr. Dieses hat mehrere optische Dipolübergänge vom Grundzustand (7S3 « 7P2,3,4) um eine Wellenlänge von l = 427 nm, die sowohl für die Fokussierung, als auch zur (sub-Doppler-) Laserkühlung nutzbar sind. Der Laserstrahl wird aus einem Ti:Saphir-Laser gewonnen, in einen Frequenzverdoppler (second harmonic generator, SHG; siehe Abbildung 19) eingekoppelt, mittels Spektroskopie an einer Chrom-Hohlkathodenzelle frequenzstabilisiert und durch akusto-optische Modulatoren frequenzverschoben. Dabei wird der eine Strahl zur Kühlung und der andere zur Erzeugung der Stehwelle benutzt.
Direkt ab dem Ofenausgang wird der Atomstrahl schon lasergekühlt. Dieses Vorgehen hat den Vorteil, daß hier die transversale Geschwindigkeitsverteilung noch "eng" ist und zudem der Fluß des 52Cr-Isotops in das Depositionsgebiet im Gegensatz zu den nicht mit dem Licht interagierenden Isotopen erhöht wird. Ziel des Kühlens ist es, den Strahl transversal zu kollimieren und den Divergenzwinkel unter 1 mrad zu senken.
Kurz vor Auftreffen auf dem Substrat, welches in allen Achsen beweglich gelagert ist (Feineinstellung mit Piezotechnik), durchläuft der Atomstrahl die Lichtmaske. Durch die Glasfaser in die Vakuumkammer geleitet, trifft der Laser direkt über dem Substrat auf einen oder mehrere Spiegel und bildet eine stehende Welle aus, die Lichtmaske.
Es hat sich als vorteilhaft erwiesen, das Substrat direkt ins Zentrum des gaußschen Strahlprofils des Lasers zu plazieren, da hier maximale Fokussierung mit kleinsten Abbildungsfehlern erreicht wird. Dies sieht man gut in Abbildung 20 anhand der simulierten Trajektorien der Atome.

Von einer Intensitätsgradienten-Lichtmaske spricht man, wenn die Polarisation an allen Punkten der Lichtmaske gleich ist. Dipolkräfte ergeben sich dann nur durch die örtlich variierende Intensität des Lichtes. Wie bereits in Kapitel 2.2.1 erwähnt, bestimmt das Vorzeichen der Verstimmung des Laserlichtes, ob Potentialminima an den Intensitätsminima (für positive/blaue Verstimmung) oder an Intensitätsmaxima (für negative/rote Verstimmung) liegen. Dieser Umstand eröffnet die Möglichkeit durch Wechsel des Vorzeichens der Verstimmung bei eindimensionalen Strukturen eine Strukturverschiebung um eine halbe Periode zu erreichen.
Im Grenzfall großer Verstimmung sind die Dipolpotentiale direkt proportional zur Intensitätsverteilung des Lichtfeldes. Aufgrund eines Auswahlkriteriums, die Wellenvektoren betreffend, können mit einer Intensitätsgradienten-Lichtmaske Atomstrahlen nur auf zwei Punkte fokusiert werden, die mindestens eine halbe Lichtwellenlänge auseinander liegen (l/2-Limit).
Ein Ergebnis der 1D-Strukturierung mittels Intensitätsgradienten (konstanzer Versuchsaufbau) zeigt Abbildung 21. Man sieht einen 6 x 6 µm großen Ausschnitt einer Linienstruktur mit 212,8 nm Abstand. Dies entspricht, wie erwartet, der Hälfte der verwendeten Lichtwellenlänge von 425,6 nm.


Aber durch ein Verfahren, dessen theoretische Grundlage bereits angesprochen wurde, kann man dieses Limit noch ein weiteres Mal halbieren. Der Aufbau wird zunächst mit negativer Verstimmung D betrieben. Es entstehen Potentialmaxima an den Intensitätsminima. Nach Ablagerung der gewünschten Menge an Depositmaterial wird das Vorzeichen der Verstimmung geändert. Die Intensitätsverteilung ändert sich dabei nicht. Bei positiver Verstimmung verhält sich das Potential proportional zur Intensität. So erhält man zwar jeweils für sich wieder nur eine maximal l/2-Periodizität, aber durch die Überlagerung kommt eine l/4-Struktur zustande (siehe Abbildung 22). Das Verfahren wird Doppelbelichtung (auch detuning switch) genannt und ist prinzipiell auch bei der Polarisationsgradientenlithographie anwendbar.
Die erreichbaren Halbwertsbreiten ohne Doppelbelichtung liegen bei 60 nm.
Die Überlagerung zweier ebener Wellen unter dem Winkel a ergibt bei beliebigen Intensitäts- und Polarisationsverhältnissen eine Linienstruktur der Periode
 |
(10) |
Um mit der Intensitätsgradientenlithographie zweidimensionale Strukturen zu erzeugen verwendet man ein Spiegelsystem, wie in Abbildung 24 dargestellt. Es überlagern hier an Spiegel 1 vier ebene Wellen unter einem Winkel von 90°. Wegen des endlichen Strahldurchmessers (gaußsches Laserprofil) beeinflussen sich die vier Strahlen auch noch in einiger Entfernung, hierbei führt jedoch die abgeschwächte Intensität dann zu Übergangsmustern; vom Linienmuster zweier überlagernder, ebener Wellen bis hin zu dem quadratsymmetrischen Punktgittermuster vierer ebener Wellen.
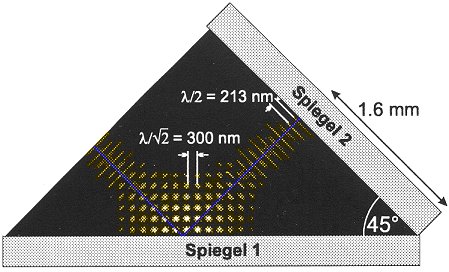
Das Ergebnis sieht man in Abbildung 25 für Rotverstimmung und in Abbildung 26 für blauverstimmte Laser. Das jeweils erste Bild stammt aus der Überlagerungsregion an Spiegel 1, das zweite aus der Nähe des Spiegels 2.




Dipolkräfte entstehen auch in Lichtfeldern homogener Intensität, aber örtlich variierender Polarisation. Am einfachsten läßt sich das auftreten der Lichtfeldpotentiale am Beispiel der bereits aus den vorhergehenden Vorträgen (im Speziellen Laserkühlung: Sisyphuskühlung) bekannten lin ^ lin-Konfiguration erklären. Das lin ^ lin-Lichtfeld besteht aus zwei gegeneinander um l/4 versetzten stehenden Wellen mit entgegengesetzt zirkularer Polarisation (siehe Abbildung 27).
Hat ein Atom mehrere magnetische Unterzustände im Grundzustand, so wechselwirken diese unterschiedlich stark (Clebsch-Gordan-Koeffizienten) mit den Polarisationskomponenten. Dieses Verhalten spiegelt sich in den Potentialkurven wider (Abbildung 28). Da bei jedem Potentialminimum eine Struktur erzeugt werden kann, erreicht man so Perioden bis zu l/4, also der Hälfte der Auflösung die mit einer Intensitätsgradienten-Lichtmaske verwirklicht werden kann.
Bei höheren Drehimpulsquantenzahlen koppelt das Lichtfeld mehrere Unterzustände des Grundzustandes über stimulierte Multi-Photon-Ramanübergänge miteinander. Es entstehen in den Potentialkurven kürzere Perioden (Abbildung 29, rechts).
Durch diesen Effekt kann man die erreichbare kleinste Entfernung benachbarter Strukturen ein weiteres Mal halbieren und erreicht so l/8. Eine so entstandene Linienstruktur kann man in Abbildung 30 sehen, auch wenn hier größere Linienabstände erzielt wurden.
Überlagern sich drei ebene Wellen in einer Ebene, so entsteht eine Struktur mit zweidimensionaler Periodizität in dieser Ebene. Interessant ist hier der Fall einer Überlagerung unter 120°. Es ergibt sich eine hexagonale Struktur mit einer Periode von 2/3 l.
Bei vier einander überlagernden Wellen kommt noch eine relative Zeitphase hinzu. So können mit Lichtmasken Übergitter erzeugt werden. Darauf soll hier aber nicht weiter eingegangen werden (Details siehe [10]).
Mit einem Abbildung 31 ähnelndem Aufbau kann man zweidimensionale Strukturen in der Polarisationslithographie erstellen. Dazu sind mindestens drei ebene Wellen nötig. Es hat sich aus verschiedenen Gründen als am besten erwiesen, genau drei ebene Wellen zu benutzen. Weiterhin ist es wichtig, daß das Lichtfeld von homogener Intensitätsverteilung ist, da bei gemischten Intensitäts- und Polarisationsgradienten die Intensitätsverteilung größeren Einfluß auf die Strukturerzeugung hat und man damit wieder auf das l/2-Limit (bzw. 2/3 l bei 2D-Strukturierung) stößt.
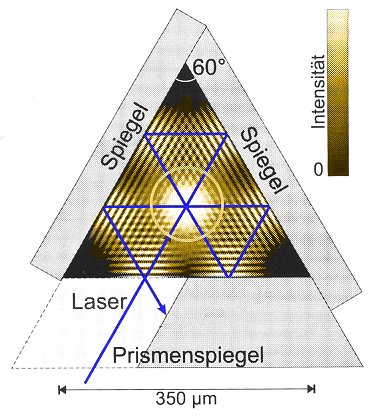
Die Polarisationsrichtungen der drei ebenen Wellen müssen dabei senkrecht zueinander stehen. Es reicht deshalb nicht, den Laserstrahl nur zweimal reflektieren zu lassen, da die Polarisationsrichtung nicht stimmt. Auch ohne den Prismenspiegel würden maximal zweidimensionale Strukturen mit der Periode 2/3 l entstehen (Intensitätsgradient). Man wählte bei den Experimenten in [10] linear polarisierte Wellen wodurch es zur Namensgebung lin ^ lin ^ lin-Konfiguration kam. Mit diesen Einstellungen erreicht man eine Struktur hexagonaler Symmetrie mit der Periode l/3, wie man sie in Abbildung 35(c) sehen kann.
Das Beugungslimit, also die volle Halbwertsbreite des kleinsten erzeugbaren Brennpunktes, berechnet sich zu:
 |
(11) |
NA ist hier die numerische Apertur, die, wie jedem Linsensystem, auch den Lichtlinsen zugeordnet werden kann. Diese entspricht in etwa:
 |
(12) |
wenn b der Linsendurchmesser und f die Brennweite sind. Nach Born und Wolf ergibt sich die Brennweite einer atomoptischen Linse äquivalent einer Dicken Linse in der Optik (auch quadratisches Potential) zu:
 |
(13) |
(w0: 1/e2-Radius des Laserstrahls).
Setzt man nun in Gleichung (11) für die de-Broglie-Wellenlänge ldB einen Wert von 8 pm (für Chrom), für die Brennweite einen Wert von f = 55 µm (entspricht einem 1/e2-Radius des gaußschen Laserstrahls von 100 µm) und für den Linsendurchmesser b = l/2 ein, so erhält man ein Limit von ddiff » 2 nm.
Simulationen mit realistischen Atomstrahlparametern ergeben stets größere Strukturbreiten, so daß das Beugungslimit nicht ins Gewicht fällt. Aber anhand der Formeln kann man erkennen, daß dem experimentellen Aufbau deutliche Grenzen gesetzt sind (Brennweite!).
Lasergekühlte Atomstrahlen lassen sich auf einen Raumwinkel von q » 0,5 mrad kollimieren. Mit der zuvor benutzten Brennweite von f = 55 µm und (14) läßt sich so eine Halbwertsbreite von ddiv » 28 nm bestimmen.
 |
(14) |
Auch hier sieht man wieder, daß eine kurze Brennweite kleinere Strukturen erlaubt.
Die folgenden Aberrationen, die durchaus als analog zu denen in 1.2.1 betrachtet werden können, haben alle die Gemeinsamkeit, daß sie die Fokusebene in Abhängigkeit von den atomaren Anfangsparametern (Eintrittsort, longitudinale Geschwindigkeit, interner Anfangszustand) verschieben. Die einzelnen Aberrationen sind nicht additiv, daß heißt sie können sich gegenseitig verstärken oder abschwächen. Es reicht nicht aus, den Einfluß eines Aberrationstyps abzuschwächen. Verbesserungen können nur bei allgemeiner Optimierung erreicht werden.
Im Experiment heißt das, es gibt immer einen gewissen Anteil Atome mit suboptimalen Anfangsparametern. Diese verbreitern die gewünschten Strukturen und bilden sogar einen gewissen homogenen Untergrund.
Die auftretenden Aberrationen sind:
Die ersten Versuche zum Schreiben mittels eines Atomstrahls wurden mit in einem Ofen erzeugten Alkaliatomstrahlen durchgeführt. Der Nachteil dieses Materials lag vor allem in der hohen Reaktivität und Beweglichkeit der Atome auf der Oberfläche, weshalb die beschichteten Substrate nicht aus dem vakuumierten Versuchsaufbau genommen werden durften und die Vermessung mittels Beugungsexperimenten durchgeführt werden mußten. Außerdem finden die Alkalis keine Anwendung in herkömmlichen Lithographieverfahren, was einen Einsatz auf diesem Gebiet mangels einer Anwendung entgegenwirkt.
Ähnliches gilt für metastabile Edelgasatome (He*, Ne*, Ar*), die sich wie auch die Alkaliatome aufgrund ihrer guten Präparierbarkeit als effektives Zweiniveausystem und ihrer einfachen elektronischen Struktur zwar besonders gut für die Laserkühlung eignen, aber technologisch nicht brauchbar sind. Es gibt jedoch auch ein Verfahren, wie man mittels metastabiler Heliumatome Strukturen in eine hydrophobe aggregierte Monolage (SAM) aus organischen Molekülen überträgt, die dann als Resist für einen folgenden Ätzprozeß dient, aber dazu später mehr (Kapitel 3.2).
Chrom hingegen ist schon durch seinen Einsatz in der klassischen Lithographie, z.B. als Maskenmaterial (Resist) für Trockenätzverfahren bekannt. Für die Atomlithographie empfiehlt es sich durch ein einfaches Termschema ohne Fein- und Hyperfeinaufspaltung, das sich gut für die effektiven Laserkühlverfahren eignet. Die entstandenen Strukturen weisen hohe Stabilität und geringe Oberflächenmobilität auf. Die Untersuchung von Chromstrukturen ist somit mit hochauflösenden Rastersonden- bzw. Elektronenmikroskopen sowie mit AFM möglich.
| [zurück] | [inhalt] | [weiter] |