1 EINLEITUNG: KLASSISCHE LITHOGRAPHIE
2.1.2 Experimenteller Aufbau
2.2.2 Dipolkraft 2.2.3 Experimenteller Aufbau 2.2.4 Intensitätsgradienten-Lichtmasken 2.2.5 Polarisationsgradienten-Lichtmasken 2.2.6 Begrenzende Prozesse
3.2 RESISTTECHNIK 3.3 GRENZEN DER VERFAHREN 5 LITERATUR 6 [ Druck-optimierte Version ] |
AtomlithographieMark Rossi
|
1965 sagte Gordon Moore, Mitbegründer der Firma INTEL, voraus, daß sich alle 18 Monate die Integrationsdichte auf Mikrochips verdoppeln werde. Bis zum heutigen Tage hat sich diese als "Moore's law" bekannte Aussage mit erstaunlicher Präzision bewahrheitet (siehe Abbildung 1).
Aber seit einiger Zeit werden immer mehr Stimmen laut, daß sich diese Serie mit der aktuellen Halbleitertechnologie nicht fortsetzen lasse. Hauptargument dieser Vorhersage ist, daß die physikalischen Grenzen der Verfahren erreicht seien. Die Roadmap der SIA verspricht aber trotz allem eine stetige Verkleinerung der Strukturen (Abbildung 2).
Die Verwirklichung dieses Ziels sieht die SIA nur bis zu einem gewissen Grade mit einer Kombination der aktuell verfügbaren Technologien gewährleistet. In Abbildung 3 stehen jeweils die gewünschten Strukturgrößen den potentiellen Technologieansätzen gegenüber. Zu beachten sei hier vor allem der Vermerk "innovative technology" für den Bereich unter 50 nm.
Zur Erläuterung der Liste: KrF, ArF und F2 (F2) ist der jeweils verwendete Lasertyp. RET ist die Abkürzung für resolution enhancement technology und schließt Verfahren, wie Phase-Shift-Masken ein, die eine Erhöhung der Auflösung unter Umgehung der gegebenen Limits ermöglichen. EPL steht für Elektronen-Projektions-Lithographie, EUV für extremes Ultra-Violett, IPL für Ionen-Projektions-Lithographie, PXL für proximity X-ray lithography und EBDW für electron-beam direct-write.
Die Photolithographie ist das bis heute dominierende Verfahren zur Mikrostrukturierung von Halbleitern. Die Gründe, warum diese, obwohl anderen Technologien wie Röntgen-, Eletronenstrahl/-projektions- und Ionenstrahl/-projektionslithographie in Auflösungs-vermögen unterlegene Verfahren trotzdem eingesetzt wird, sind vor allem wirtschaftlicher Natur, da komplexere Produktionsstätten zwingend sind.
Um die Begrenzung der Photolithographie durch die Physik zu verstehen, soll an dieser Stelle zunächst einmal das zu Grunde liegende Konzept der Lithographie erläutert werden.
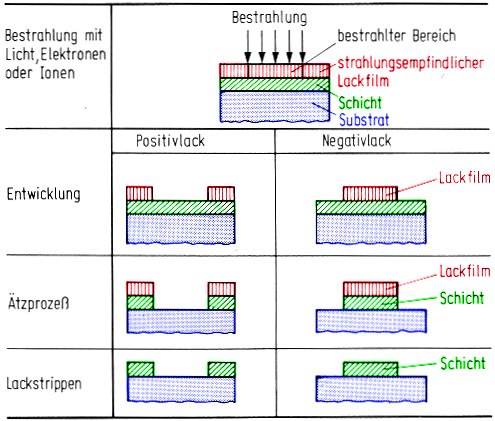
Die Aufgabe der Lithographie besteht darin, Strukturen von einer Maske auf ein Substrat zu übertragen. Das wesentliche Merkmal dieser Technik ist eine strahlungsempfindliche Resistschicht, die in den gewünschten Bereichen so bestrahlt wird, daß in einem geeigneten Entwickler nur die bestrahlten (oder unbestrahlten) Bereiche entfernt werden. Das so entstandene Resistmuster dient dann als Maske für den darauffolgenden Prozeßschritt, wie zum Beispiel einer Ätzung oder einer Ionenimplantation. Abschließend wird die Resistschicht wieder abgelöst (siehe auch Abbildung 4).
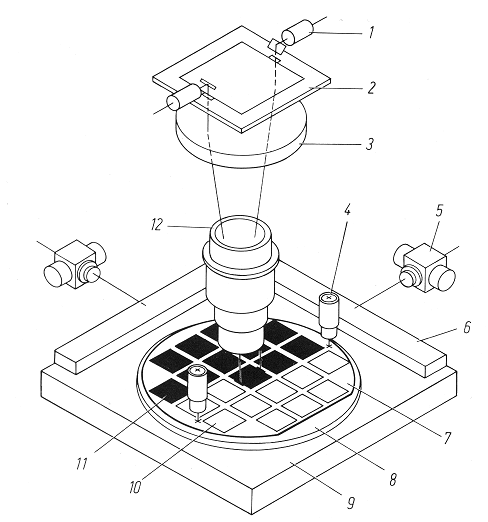
Die verkleinernde Projektionsbelichtung ist ein kontaktfreies Verfahren zur Belichtung, bei dem das Abbild der Fotomaske, über ein Linsensystem verkleinert, auf die Fotolackoberfläche des Halbleiters projiziert wird. Abbildung 5 zeigt den dafür benutzten Aufbau, einen Waferstepper. Die Verkleinerung liegt im allgemeinen zwischen 1 und 10. Aufgrund der Verkleinerung kann nicht mehr die gesamte Halbleiterscheibenoberfläche auf einmal belichtet werden. So wird der Probentisch mit jedem Belichtungsvorgang ein weiteres Stück verschoben (step-by-step-Verfahren). Die Vorteile dieser Methode liegen auf der Hand:
Das Auflösungsvermögen des zuvor besprochenen Belichtungsverfahren erhält man über folgende Betrachtungen und unter Zuhilfenahme der Abbildung 6.

Eine Beleuchtungsoptik bildet die Lichtquelle durch die Maske in die Objektivöffnung ab. Dabei wird das Licht an den Strichmustern der Maske gebeugt. Somit entstehen in der Ebene der Objektivöffnung nicht nur das eigentliche Bild (nullte Beugungsordnung), sondern auch Beugungsbilder höherer Ordnung. Der Winkel zwischen den Beugungsordnungen sei q und es gelte bei kleinen Winkeln q die Näherung:
 |
(1) |
sina beziehungsweise a wird als numerische Apertur (NA) definiert:
 |
(2) |
Da jede Beugungsordnung einen Teil der Bildinformation in sich trägt, ist die Abbildung um so getreuer, je mehr Beugungsordnungen in die Objektivöffnung fallen. Die Auflösungsgrenze ist dann zu erwarten, wenn auch die beiden ersten Beugungsordnungen aus der Objektivöffnung verschwinden. Dieser Fall ist gegeben für:
 |
(3) |
Mit den Beziehungen (1) und (2) ergibt sich die minimale übertragbare Strukturbreite zu:
 |
(4) |
Da die numerische Apertur nach (2) maximal 1 werden kann, ergibt sich das physikalisch minimale Größenlimit zu:
 |
(5) |
Die Nachteile der verkleinernden Projektionsbelichtung liegen in der langen Belichtungszeit: die kleinen Flächen müssen genauso lange belichtet werden, wie die großen, nur daß da mit einem Durchgang die gesamte Halbleiterscheibe schon ihre Strukturen aufgeprägt bekommen hat.
Zudem können verkleinernde Belichtungssysteme mit tiefem UV-Licht nur schwer realisiert werden. Nicht nur, daß nur wenige brauchbare Lichtquellen in diesem Bereich des EM-Spektrums bekannt sind, es gibt in diesem Bereich zudem kaum noch transparente Medien zur Herstellung der Abbildungsoptiken. Die letzte nutzbare Linie im Quecksilber-Lampen-Spektrum liegt bei 253,7 nm (siehe Abbildung 7).
Aktuell und in Zukunft kommen aber immer mehr UV-Laser zum Einsatz:
| Wellenlänge [nm] | Lasertyp |
| 248 | KrF |
| 193 | ArF |
| 157 | F2 |
Da die Belichtungsoptiken meistens aus Linsen (-systemen) bestehen, treten natürlich die aus der geometrischen Optik bekannten Linsenfehler auf und beeinträchtigen die erreichbare Auflösung im negativen Sinne. Nicht zuletzt, um in der Folge Parallelen aufzeigen zu können, seien sie hier noch einmal genannt und erläutert.
Sphärische Aberration werden durch Strahlen erzeugt, die in unterschiedlichen Achsentfernungen die Linse durchlaufen. Da die Brecheigenschaften der Linse aber aufgrund der unterschiedlichen Dicke nicht in allen Entfernungen von der optischen Achse gleich sind, kommt es zur Ausbildung unterschiedlicher Brennpunkte, wie Abbildung 8 zeigt.
Astigmatismus ergibt für kreisförmige und radiale Elemente, die sich in der Objektebene befinden, eine scharfe Abbildung in zwei unterschiedlichen Bildflächen. Dies kommt aus einer Verletzung der Symmetrie für nichtaxiale Gegenstandspunkte. Man muß sagittale und meridionale Ebene getrennt behandeln.
Abbildung 10 zeigt typische Bilder eines solchen Abbildungsfehlers anhand zweier unterschiedlicher Objekte.
Dieser Linsenfehler entsteht aufgrund der Wellenlängenabhängigkeit der Brechzahl n(l). Daher ist auch der Fokus beziehungsweise Brennpunkt f eine Funktion der Wellenlänge f(l), wie in Abbildung 11 dargestellt. Man sieht sehr gut, daß rote und blaue Strahlen verschiedene Brennpunkte haben.
| [inhalt] | [weiter] |